Zeta-20 光学轮廓仪
产品描述
Zeta-20台式光学轮廓仪是一款非接触式3D显微镜及表面形貌量测系统。该3D光学量测系统由ZDot技术及多模式光学组件提供支持,可支持各种样品测量:透明和不透明、低反射率和高反射率、光滑表面和粗糙纹理,以及从纳米到厘米范围的台阶高度。
Zeta-20台式光学轮廓仪集六种不同的光学量测技术于一身,是一款可灵活配置且易于使用的系统。ZDot测量模式同时收集高分辨率的3D扫描信息和样品表面真彩色图像。其他3D测量技术包括白光干涉测量法、诺马斯基光干涉对比显微法和剪切干涉测量法,膜厚测量包含使用ZDot模式测量和光谱反射的测量方法。Zeta-20也是一款高端显微镜,可用于抽样检查或缺陷的自动检测。Zeta-20通过提供全面的台阶高度、粗糙度及薄膜厚度测量以及缺陷检测功能来支持研发和生产环境。
主要功能
● 配合ZDot及多模式光学组件,光学轮廓仪可以容易地实现各种各样的应用
● 用于抽样检查和缺陷检测的高质量显微镜
● ZDot:同时采集高分辨率3D扫描数据和样品表面真彩色图像
● ZXI:采用z方向高分辨率的广域测量白光干涉仪
● ZIC:亚纳米级粗糙度表面的定量3D数据干涉对比,图像对比度增强,可实现亚纳米级粗糙度表面的定量分析
● ZI:白光干涉技术,大视场下纳米级高度的理想测量技术
● ZSI:z方向高分辨率图像的剪切干涉测量法
● ZFT:通过集成式宽频反射测量法测量薄膜厚度和反射率
● AOI:自动光学检测,并对样品上的缺陷进行量化
● 生产能力:具有多点量测和图形识别功能的全自动测量
主要应用
● 台阶高度:纳米级到毫米级的3D台阶高度
● 纹理:光滑表面到粗糙表面的粗糙度和波纹度测试
● 翘曲:2D或3D翘曲和形状
● 应力:2D或3D薄膜应力
● 薄膜厚度:30nm到100μm的透明薄膜厚度
● 缺陷检测:捕获大于1μm的缺陷
● 缺陷复检:KLARF文件可用于寻找缺陷,以确定划痕缺陷位置,测量缺陷3D表面形貌
台阶高度
Zeta-20能够非接触式测量从纳米级到毫米级的3D台阶高度。ZDot和多模式光学组件可提供一系列方法来测量台阶高度。ZDot是主要测量的技术,可以快速测量从几十纳米到毫米级的台阶。ZXI干涉测量可用于在大范围内测量从纳米级到毫米级的台阶。ZSI剪切干涉测量可用于测量不到80nm的台阶。

薄膜厚度
Zeta-20能够使用ZDot或ZFT测量技术测量透明薄膜的薄膜厚度。ZDot用于测量大于10µm的透明薄膜,例如覆盖在高折射率的衬底上的光刻胶或微流体器件层。ZFT使用集成宽频反射仪测量30nm至100µm的薄膜。这既可以运用于单层,也可以运用于多层薄膜堆叠,用户可以输入薄膜的性质或使用模型来拟合光谱。

纹理:粗糙度和波纹度
Zeta-20测量3D纹理、量化样品的粗糙度和波纹度。ZDot可以测量从几十纳米到非常粗糙的表面的粗糙度。ZSI和干涉测量可以测量从埃级到微米级的光滑表面。软件中的过滤器将测量结果分为粗糙度和波纹度两部分,并计算出均方根粗糙度等参数。诺马斯基光干涉对比显微法可以通过揭示斜率的微小变化来可视化非常精细的表面细节。

翘曲:翘曲,形状
Zeta-20可以测量表面的2D和3D形状或翘曲。这包括半导体或化合物半导体器件生产过程中层间不匹配导致的晶圆翘曲的测量。Zeta-20还可以测量结构(例如透镜)的3D高度和曲率半径。

应力:薄膜应力
Zeta-20能够测量具有多个工艺层的器件(例如半导体或化合物半导体器件)在生产过程中的应力。精确测量表面的翘曲度需要使用应力载台将样品支撑在中间位置。然后运用Stoney公式的原理根据工艺(诸如薄膜沉积)带来的形貌变化来计算应力。Zeta-20通过在整个样品直径上以用户定义的间隔测量样品表面的高度,然后把数据合成样品形状的轮廓来测量2D应力。

自动缺陷检测
Zeta-20能够通过自动光学检测 (AOI) 快速检测样品,区分不同的缺陷类型,并绘制整个样品的缺陷分布图。当与3D量测功能结合使用时,Zeta-20可以提供2D检测系统无法提供的缺陷高度信息,从而更快地分析缺陷来源。

缺陷表征
Zeta-20缺陷表征使用检查工具KLARF文件将样品台移动到缺陷位置。用户可以使用Zeta-20检测缺陷或测量缺陷的表面形貌,例如高度、厚度或纹理。这提供了更多无法从2D缺陷检测系统获得的缺陷细节。Zeta-20还可以使用划线标记缺陷,从而使视场有限的工具(例如SEM)更容易找到缺陷。

光伏太阳能电池
Zeta-20光学轮廓仪非常适合太阳能电池应用,因为它支持测量同时具有非常低和非常高反射率材料的表面。该系统可以量化蚀刻后纹理——反射率不到1%的金字塔结构,这对太阳能电池的光捕获能力至关重要。与这些纹理相邻的是反射率大于90%的银浆接触线。具有ZDot和高动态范围测量技术的Zeta-20可以同时测量反射率非常低和非常高的区域,量化银浆线的高度、宽度和沉积银浆体积,从而确定电阻数值。此外,Zeta-20还可用于测量来料硅片的粗糙度、隔离沟道深度、样品翘曲度、应力和3D缺陷,使用ZFT还可以测量氮化物膜厚度。

半导体和化合物半导体封装
Zeta-20支持晶圆级芯片封装 (WLCSP) 和扇出晶圆级封装 (FOWLP) 量测要求。一个主要的赋能技术是在干光刻胶膜完好无损的情况下测量镀铜的高度。这是通过从透明光刻胶到种子层测量铜柱的高度、光刻胶的厚度以及铜和光刻胶的相对高度差来实现的。其他应用包括重布线 (RDL)、凸点下金属化 (UBM) 高度和纹理、光刻胶开口临界尺寸 (CD)、光刻胶厚度和聚酰亚胺厚度的测量。还可以测量金属凸点的共面性,以确定凸点高度是否满足终端器件封装连接性要求。

印刷电路板 (PCB) 和柔性 PCB
Zeta-20 的高动态范围模式可实现从纳米级到毫米级的表面粗糙度和台阶高度测量,无需更改配置。它可以处理高反射率薄膜(例如铜)以及 PCB 上常见的透明薄膜。Zeta-20支持盲孔、线痕和热压焊的关键尺寸测量(高度和宽度)以及表面粗糙度。

激光烧蚀
Zeta-20 可以测量半导体、LED、微流体器件、PCB等的激光表面处理引起的表面形貌变化。激光已被用于半导体、LED和生物医学设备等行业的精密微观尺度加工和表面处理。对于半导体行业,晶圆ID标记的深度和宽度的测量对于确保它可以在众多加工步骤中成功读取至关重要。Zeta-20可以测量柔性电路和晶圆上创建的高深宽比孔的台阶高度。它还可以测量太阳能电池隔离沟道的深度和宽度,从而提高器件效率。

微流体
Zeta-20能够测量由硅、玻璃和聚合物等材料制成的微流体器件。该系统量化了通道、孔和控制结构的高度、宽度、边缘轮廓和纹理。Zeta-20可进行折射率补偿,测量用透明顶盖板密封后的终端器件,从而监测腔道的深度。

生物技术
Zeta-20非常适合生物技术应用,可对具有从纳米级到毫米级特征的各种样品表面进行非接触式测量。Zeta-20可以测量高高宽比台阶,例如生物技术器件的深孔的深度。借助高数值孔径物镜和对反射能力非常弱的样品的分辨能力,可以测量用于药物输送的微针阵列结构。

数据存储
Zeta-20 CM专门用于测量磁盘边缘几何图形和检查污染或损坏。在磁盘的边缘,顶面表面和侧面之间的转变必须具有光滑的斜切面,否则磁盘边缘的扰动可能导致读写头在磁盘上遭受毁灭性的撞击。该系统配置包括一个倾斜样品台,用于在边缘测量和检测期间旋转圆盘。

适用行业
● 太阳能:光伏太阳能电池
● 半导体和化合物半导体
● 半导体WLCSP(晶圆级芯片级封装)
● 半导体FOWLP(扇出晶圆级封装)
● PCB(印刷电路板)和柔性PCB
● MEMS(微机电系统)
● 医疗器械和微流体器件
● 数据存储
● 大学,实验室和研究所
● 还有更多:请联系我们以探讨您的需求
选配件
ZFT:Zeta薄膜厚度
Zeta-20拥有集成式宽频光谱仪,用于测量厚度30nm至100µm的透明薄膜。它能够测量单层或多层堆叠薄膜的厚度,用户从材料库中选择折射率值。可绘制样品上的薄膜厚度分布图,以确定样品的均匀性。
ZFT可运用在一些反射率非常低的表面,例如反射率低于0.1%的太阳能电池。很多薄膜厚度测量机台难以从这些类型的表面上获得信号,因为它们依赖于镜面反射光来计算相位变化或其他参数。宽频白光和垂直入射光源可支持该机台用于各种低反射率光学透明薄膜。

ZXI:Zeta干涉测量技术
Zeta-20 与压电载台及干涉物镜结合使用,可支持相位扫描干涉测量法 (PSI) 和垂直扫描干涉测量法 (VSI)。PSI 支持快速测量几埃到数百纳米的台阶高度。VSI支持从数百纳米到数百微米的台阶高度测量。无论物镜数值孔径的大小,两者的分辨率均好于纳米级。

ZIC:Zeta 干涉对比
Zeta-20 采用诺马斯基光差分干涉对比显微法来提供精细表面细节的增强影像。诺马斯基光差分干涉对比显微法采用偏振和棱镜来更改相位,从而增强样品表面坡度的变化。这能让超光滑表面上的缺陷可视化,例如单层污染物。ZIC 扫描模式可通过将坡度变化与其他技术测量的粗糙度相关联,将这些图像转化为亚纳米级粗糙度的定量测量。

ZSI:Zeta 剪切干涉测量法
Zeta-20剪切干涉测量技术 (ZSI) 通过改变相位来强化ZIC测量。采集具有不同相位的多幅影像,然后通过先进的算法加以处理,以生成具有埃级分辨率的表面形貌的定量测量。该技术无需干涉物镜和z方向载物台扫描,即可完成从几埃到80nm的高分辨率测量。

物镜
提供多种物镜,包括 1.25 倍至 150 倍的常规物镜、长工作距离物镜、超长工作距离物镜、折射率校正物镜、透射式物镜、液体浸没式物镜和垂直扫描干涉物镜。

耦合器
Zeta-20 可配置四种不同的光耦合器,以改变光学放大倍率。该系统可配置 1 倍耦合器,以保持初始放大倍率,或配置 0.35 倍、0.5 倍或 0.63 倍耦合器,以提高放大倍率。

物镜转台
Zeta-20可配置 5 位或 6 位手动转台,以及一个用于自动物镜识别的物镜传感器。该系统还可以配置一个可实现全自动操作的 6 位自动转台。

样品光照
Zeta-20采用双高亮白色LED作为标准光照。通过样品载台的背光也可增强光线用来测试具有挑战性的透明样品。Zeta-20还支持使用侧光源的暗场照明。

样品台
Zeta-20可以配置各种样品台以提高系统性能。在 ZDot或 ZXI 测量模式下测量纳米级台阶高度,可以添加压电 Z 轴平台提高 z 分辨率。Z 样品台可以安装在转环上,使测量头能够围绕样品旋转,从而改变表面入射角。XY样品台可配置手动100或300毫米行程,或电动150或200毫米行程。可以将手动旋转样品台添加到 XY 样品台上。可添加手动调节的倾斜样品台,从而调平样品载台,以便进行干涉测量。

样品载台
Zeta-20可提供支持各种应用要求的载台。太阳能样品需要搭配156毫米的样品载台,或太阳能倾斜边缘载台以便倾斜样品,测量其边缘。背光载台可用于透明衬底,以支持透射照明。可提供300毫米的晶圆载台。如果我们没有您需要的载台,请联系我们提出您的需求。

防震台
Zeta-20的系统底座内置被动防震脚。如需额外防震,还可以提供被动或主动台式防震台。

台阶高度和薄膜厚度标准片
Zeta-20使用由 VLSI 提供的可追踪台阶高度的 NIST 薄膜和厚膜标准片。这些标准片在蚀刻的石英台阶上覆盖了铬涂层。可提供8纳米至250微米的台阶高度。
现有经过认证的多台阶标准片具有8、25、50 和100µm的名义台阶高度。该标准片具有用于XY校准的各种间距的图形。适用于ZFT的经过认证的厚度标准片由一个可供参考的硅表面和名义厚度为270nm的二氧化硅薄膜组成。还有可供参考的粗糙度和镜面样品等。

多点测量功能
多点测量功能利用电动XY样品台能让用户对样品上的测量位置进行设计。该系统会自动测量每个点位,并在用户定义的文件夹中保存结果。还会生成一份统计数据输出报告来概括结果。
高级序列软件包括图形识别可自动对齐样品。可全自动测量,免受操作员失误的影响。在样品台上嵌入标准片后,可启用自动校准。

拼接软件
自动图像拼接软件使用电动 XY 样品台来组合相邻扫描,可生成比单一视场更大的拼接数据集。该系统可自动测量每个点位、对齐图像,并将它们组合成一个数据集。可以像分析任何其他结果文件一样分析结果。

Apex分析软件
Apex分析软件通过一套扩展的找平、过滤、台阶高度、粗糙度和表面形貌分析技术增强了该工具的标准数据分析能力。Apex支持ISO粗糙度计算方法以及当地标准,例如ASME。Apex还可以作为报告编写平台,能够添加文本、说明和通过/失败标准。Apex 支持 11 种语言。

离线分析软件
Zeta-20离线软件具有与该机台相同的数据分析和程式创建功能。这使用户能够创建程式和分析数据,而不占用机时。

相关产品
|
|
 |
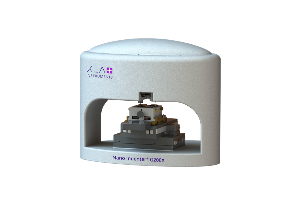 |